分光エリプソメーターとは(薄膜特性評価)
分光エリプソメーター(薄膜特性評価)は、精密な薄膜評価を必要とする幅広い分野で活用されている装置です。
アプリケーションとしては、主にシリコン半導体やSiC、GaNなどの化合物半導体、有機ELなどのフラットパネルディスプレイ、ペロブスカイトなどの太陽電池の製造工程や研究開発現場で薄膜の検査用途に使用されています。
エリプソメーターの発展版として誕生した分光エリプソメーターは、物質の屈折率nと消衰係数 kの周波数依存性(n, kスペクトル)が、光電場に対して物質が応答することで決まる関係を考慮したスペクトル解析を行うことにより、従来の単一波長による測定とは本質の異なった、より精度の高い測定を可能としています。
エリプソメーターとは
エリプソメーター(Ellipsometer)とは日本語で楕円偏光解析装置のことで、光を利用して膜の厚みや屈折率などを計測する機器です。現場では、「エリプソ」と省略して呼ばれることもあります。
光源から斜めに照射された光がサンプルに当たり、反射してセンサで受光したとき、光の変化具合によって膜の厚みや屈折率などが分かる仕組みです。よって正しい数値を出すには、サンプルを置いた基板もしくはサンプルの表面で、光が十分に反射する状態で計測する必要があります。
エリプソメーターはレーザーを光源とする単波長タイプと、白色光を光源とする分光タイプの2種類があり、より複雑な測定をする場合は分光タイプが適しています。
分光エリプソメトリー測定法の長所・特徴
エリプソメーターは、サンプル表面から反射された光の偏光の状態変化(ΨΔ)を測定することにより、サンプル(薄膜、基盤)の膜厚値T(Thickness)、屈折率N(Refractive index)、消衰係数K(Extinction coefficient) を求める光学測定装置です。単層膜から多層膜の各層の膜厚値と光学定数(屈折率、消衰係数)を非接触・非破壊で測定することが可能です。
分光エリプソメーターでは、膜厚値は、サブナノメートルから数十マイクロメートルの範囲で精度良い測定ができ、一般的な酸化膜、窒化膜、フォトレジストを含む半導体材料からディスプレイ用の有機膜や透明導電膜、また金属薄膜や表面粗さ測定まで幅広いアプリケーションでご使用頂いています。
分光エリプソメーターは消光法 ( null ellipsometry ) と測光法 ( photometric ellipsometry )の2種類の測定機構があり、それぞれの特徴は以下のとおりです。
- 消光法:直交ニコルの偏光子配置において検光子の消光状態(透過光量 が0 になる状態)を利用した、プローブ光の偏光状態を測定する方法
- 測光法:消光状態にしないまま、検光子通過後の光強度を測定する方法
検光子を回転させ、まず透過光量が 0 になるよう操作する消光法は、測定分解能が高いメリットがある一方で操作が容易ではなく、測定時間が長くなりやすいデメリットもあります。基本的には分光エリプソメトリーには不向きな方法です。
一方の測光法は透過光量を 0に煩雑な操作をする必要がなく、測定時間を短縮できることから、最近は 分光エリプソメーターの主流となっています。市販されている装置のほとんどは測光法を採用しており、更に回転検光子型や回転補償子型、位相変調型と細かく分けることができます。最近は、更にCCD検出器やフォトダイオードアレイで測定速度の改善をはかったタイプが一般的となりました。
エリプソメーターは、解析ツールです
エリプソメーターでは、サンプル表面で反射された光の偏光の状態(ΨΔ)を測定し、このスペクトルを解析することによりサンプルの膜厚値、屈折率、消衰係数などの物理量を求めることができます。
多層膜の場合は、各層の膜厚値(T1,T2,T3・・・)、屈折率(n1,n2,n3・・・)、消衰係数(k1,k2,k3・・・)を非接触で測定することができます。
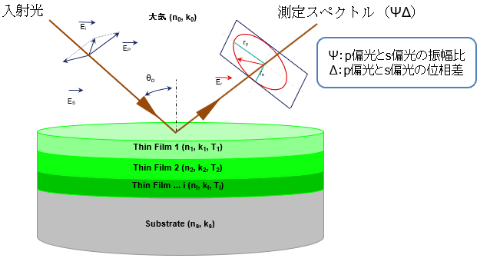
光学モデル(分散式)による解析アプローチ
薄膜の膜厚値、光学定数(屈折率、消衰係数)を求めるためには、測定データ(ΨΔ)に対して解析を行う必要があります。
解析では、サンプル構造(基板材料、薄膜材料など)の情報から光学モデルを作成することになります。
解析において、薄膜の光学定数(屈折率、消衰係数)を表すためにCauchy、Drude、Lorentz、Tauc-Lorentzモデルなどの誘電関数モデル(dielectric function models)を用いるケースが多いです。

解析プロセス(Analysis process)
ユーザーにより光学モデルが作成された後に、コンピューター(解析ソフトウェア)が自動でフィッティング作業をして解析を行います。
光学モデルが妥当な場合、測定データ(ΨΔ)と光学モデルによるシミュレーションデータ(Ψ’Δ’)が、ほぼ一致したフィッティング結果が得られ、この解析結果として、サンプルの膜厚値、屈折率、消衰係数などの物理量が得られます。
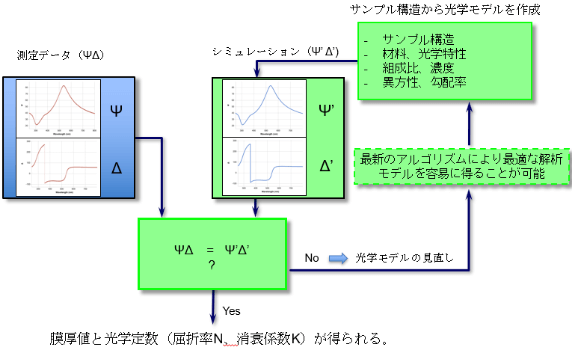
測定結果イメージ: シリコン基板上のHfO2
参考例として、シリコン基板上の酸化ハフニウムHfO2薄膜の解析結果です。
サンプル中心ポイント(1ポイント)の解析結果として、測定データ(ΨΔ)と光学モデルによるシミュレーションデータの解析グラフ、薄膜の膜厚値、屈折率、消衰係数が得られます。NK値(屈折率、消衰係数)は、スペクトルデータ(NK値vs波長)としても出力ができます。
分光エリプソメーターでは、サンプル面内の複数の測定ポイントを解析することにより、マッピンググラフ(面内分布)の結果を得ることができます。