汚染分析
セミラボでは、半導体サンプルを分析する幅広いソリューションをご用意しています。これらの全ソリューションの目的は、半導体デバイスに関する情報をできる限り多く提供し、サンプルの挙動と特性の原因や、使用したプロセスによる影響を理解できるようにすることです。
セミラボのDLS-1000の最新式のDeep Level Transient Spectroscopy(DLTS)の使用により、半導体中の電気的に活性な不純物の定性・定量分析を実行できます(ただし、これは破壊的手法です)。DLTSでは、不純物と断面積捕獲の活性化エネルギーに関する情報を提供します。また、ドーピング濃度に応じて、濃度が2×108 atoms/cm3までの不純物も検出できます。
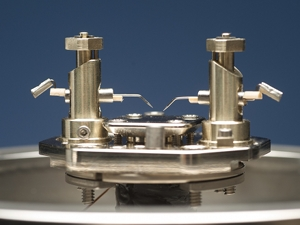 図1.汚染(コンタミネーション)分析
図1.汚染(コンタミネーション)分析
DLTS (Deep Level Transient Spectroscopy) とは
Deep Level Transient Spectroscopy(DLTS)は、汚染(コンタミネーション)や結晶欠陥による半導体中の電気的に活性な欠陥(「トラップ」)の検出と特定を行う強力な技術です。この技術は、深いトラップに関連するエネルギーレベル、捕獲断面積、濃度分布などのあらゆるパラメータを決定するための非常に汎用的な方法です。不純物の特定が可能であり、濃度が2×108 atoms/cm3以下の汚染を検出できます。
DLTSは、ショットキーダイオードまたはPN接合と小型サンプル(通常は完成ウェハーから切断されたもの)との成形を必要とするため、破壊的手法です。
セミラボのDLTSシステムは、DLS-83DまたはDLS-1000と、セミラボが提供する4種のクライオスタットのいずれかで構成されます。

キャリア・ライフタイム(µ-PCD、QSS-µPCD)
マイクロ波検出フォトコンダクタンス減衰(µ-PCD)法によるキャリア・ライフタイム測定は、ウェハー製造や太陽電池製造におけるウェハー検査、品質管理、プロセスモニタリングに役立つ技術です。マイクロ波誘導フォトコンダクタンス減衰法は、シリコンの少数キャリア・ライフタイムを測定する最も一般的な方法です。この方法は高い信頼性と再現性を誇り、短い測定時間で高分解能のライフタイムマップが作成できます。
汚染物質の頻発とそのライフタイムにより、効率が損なわれます。
|
影響度 |
元素 |
|---|---|
|
強 |
Fe、Pt、Cu |
|
中 |
Pd |
|
弱 |
Mo、W |
|
ごくわずか |
Ca、Al、Zn、Ti |

汚染物質は、ライフタイム(あるいは拡散長)への影響が異なる2つの分子状態で存在する可能性があります。
汚染物質の状態を変化させることによって生じるライフタイムの変化で、その汚染物質の量を測定します。
- 状態を変化させる独自の方法が必要
- 定数は経験的に導かれる
- 汚染物質がライフタイムに与える影響は注入レベルによって異なる場合がある
- 変化はμ-PCD法またはSPV法で検出できる









