オフラインプロセス管理
最高の品質管理は、
製造プロセスで各ウェハーを確認するインラインプロセスモニタリングによって実現できます。
しかし、サイクルタイムが短い場合(通常は1秒未満)ウェハーの詳細な分析が不可能な時もございます。
詳細な分析には、機械的接触が必要な手法・フルウェハーマッピングが必要になる場合があるためです。
当社の測定装置は、非破壊法を採用し、限りなく非接触法を用いるよう設計されています。
- ・測定が高速
- ・操作が簡単
- ・コストが低い
アプリケーションの例は以下のとおりです。
- ・ウェハーの特性評価
- ・異なる製造段階における電気パラメータの測定
- ・成膜層パラメータの特性評価
- ・表面パッシベーションの効率と均一性のモニタリング
フォトルミネッセンスイメージング
シリコンブロックの高分解能・高速のバルクライフタイム測定は、
フォトルミネッセンスイメージングにより実現します。
測定中に、電荷キャリアペアがシリコンブロックの高輝度照射で励起されます。
照射は電荷キャリアの再結合に影響を与え、
与えない場合、欠陥が存在しており放射再結合の可能性があります。
放射再結合中にフォトンが放出され、IRカメラで検出できます。
結果的に作成される画像「マップ」は、
シリコンブロックと結晶欠陥の純度に関する情報を提供します。
PL強度は、欠陥密度・不純物濃度に反比例し、
業界標準であるセミラボのµ-PCD値で校正してライフタイムに変換できます。
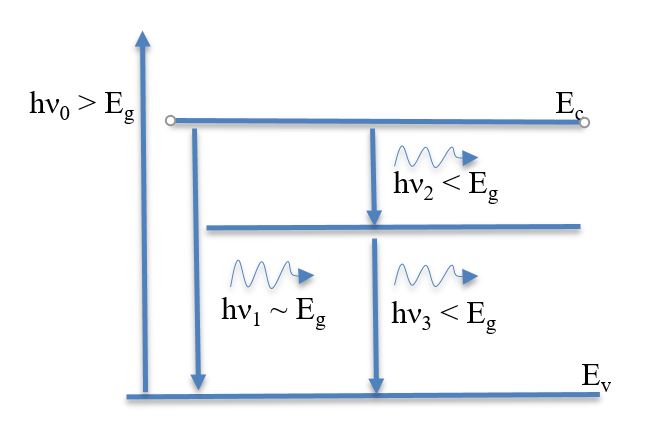
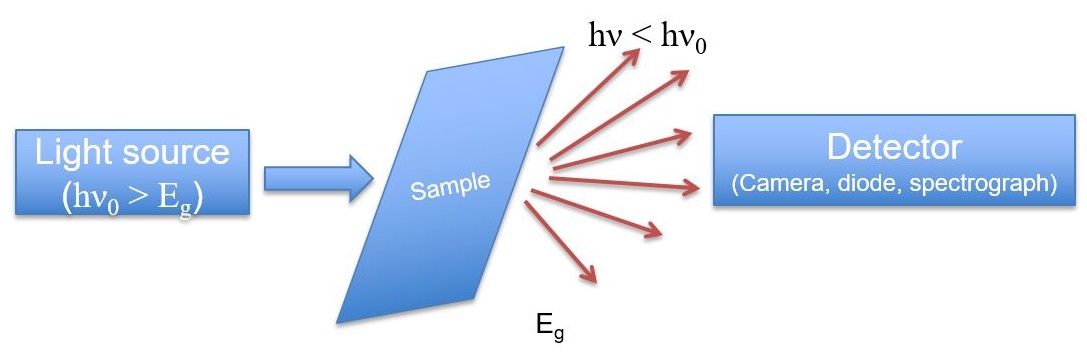
キャリア・ライフタイム(µ-PCD、QSS-µPCD)
マイクロ波検出フォトコンダクタンス減衰(µ-PCD)法によるキャリア・ライフタイム測定は、ウェハー製造や太陽電池製造における入りウェハー検査、品質管理、プロセスモニタリングに役立つ技術です。マイクロ波誘導フォトコンダクタンス減衰法は、シリコンの少数キャリア・ライフタイムを測定する最も一般的な方法です。この方法は高い信頼性と再現性を誇り、短い測定時間で高分解能のライフタイムマップも作成できます。
汚染物質の頻発とそのライフタイムにより、効率が損なわれます。
|
影響度 |
元素 |
|---|---|
|
強 |
Fe、Pt、Cu |
|
中 |
Pd |
|
弱 |
Mo、W |
|
ごくわずか |
Ca、Al、Zn、Ti |

4探針プローブによるシート抵抗測定
4探針プローブ(4PP)は、ドーピング密度、抵抗率、エミッターシート抵抗値のモニタリングを行うために広く使用されている接触測定法です。電圧と電流の電極を分離することで、接触抵抗の影響を測定結果から排除します。使用電圧が制限されているため、高抵抗率範囲では測定可能な電流が非常に小さくなり、これが測定に対する制限となります。当社では、6探針プローブ(6PP)法を用いることでこの問題を解決し、探針を2本追加して測定ノイズを可能な限り抑制しています。
シート抵抗測定
シート抵抗測定(SHR)は、PN接合に適用できます。
SHRは、ドーピング濃度とジャンクション深さに左右され、拡散プロセスの特性評価に適しています。
動作の原理は、n+pまたはp+n層構造の光励起と、
それから生じる表面電位のキャパシタンスプローブによるピックアップに基づいています。
検出電位は材料のシート抵抗で決定されます。
Warning: foreach() argument must be of type array|object, string given in /home/xb203021/semilab-j.jp/public_html/cms/wp-content/themes/semilab-j/single-products.php on line 150