エピ抵抗率測定
CVDプロセスでシリコンのブランケット層をシリコン基板に追加することで、抵抗率、N型P型、結晶欠陥密度などの物理特性を変化させることができます。このCVDプロセスはエピ(Epi、またはエピタキシャル)成膜と呼ばれます。エピ層の厚さのモニタリングは、エピウェハーの製造プロセスの一環として行われています。このモニタリングは、サンプルベースで行われますが、エピタキシャルリアクタが正しく設定されていることを確認するためにのみ行われることもあります。
セミラボでは、赤外反射法などの検査装置により、エピ膜厚モニタリングの非接触光学ソリューションをご提供しています。
 図1.抵抗率測定フロー
図1.抵抗率測定フロー
エアギャップCV測定
エアギャップCV(ACV)技術は、エピ層(エピタキシャル層)やシリコン基板抵抗率の非接触測定を可能にするために、従来の測定手法でモニターする場合に生じていたテストウェハーのスクラップをなくし、コストを削減します。あらゆる型のエピ基板を非接触でモニターすることができます(p/p+、n/n+、p/p-、n/n+/p+、ベアn、n表面)。
水銀CV測定とは
水銀CV測定装置(MCVシステム)では、空気圧制御式の非破壊プローブ設計とサンプル表面での水銀接触により、従来の手法であるコストのかかる金属・ポリ蒸着プロセスを不要にします。接触領域が非常に安定しており、少量の水銀を使うだけで再現性の高いCV・IV測定が可能であり、プロセス開発やプロセスモニタリングなどの用途に役立ちます。MCV法は、バルク/エピタキシャルと誘電材料の両方の特性評価に効果的です。
表面電荷プロファイリング(QC)
交流SPV分析(ac-SPV)
ac-SPV(ac-Surface Photo Voltage)は電気光学的手法であり、半導体の基板表面、または厚さ数ミクロンの絶縁体で覆われた表面の電気特性を高速かつ非破壊で評価できます。この手法では、複数の重要なパラメータ(表面近傍のドーピング濃度、抵抗率、表面のライフタイム、表面の導電型など)を同時に特定することができます。
拡がり抵抗測定とは(SRP)
拡がり抵抗測定(SRP)では、シリコンデバイス全体のキャリア濃度、深さ、抵抗率プロファイルを確認できます。SRPでは、キャリア濃度範囲、導電型、方位、プロファイル深さに対する実際的な制限はありません。SRPを使うことで、設計者は自分のモデルが実際の製作デバイスをどれほど正確に表しているかを簡単に確認でき、歩留向上のためにプロセスエンジニアは、製造プロセスから「フィンガープリント」を採取して故障分析を簡単に行うことができます。さらに、プロセスエンジニアは、エピ(Epi)、イオン注入、拡散などのすべてのシリコンドーピング操作のトラブルシューティングを実行できます。
測定できる物理量:
- 抵抗(R、Ω) :電圧を電流で割ったもの
- シート抵抗(Rs、Ω/sq) :厚さが(名目上)均一である薄膜の抵抗
- 抵抗率(ρ、Ωcm) :材料(半導体層)の固有の抵抗率
- ドーピング濃度(cm-3) :一定量中のドナーまたはアクセプター原子の数
- キャリア密度(n、cm-3):一定量中の電気的に活性な電子または正孔の数
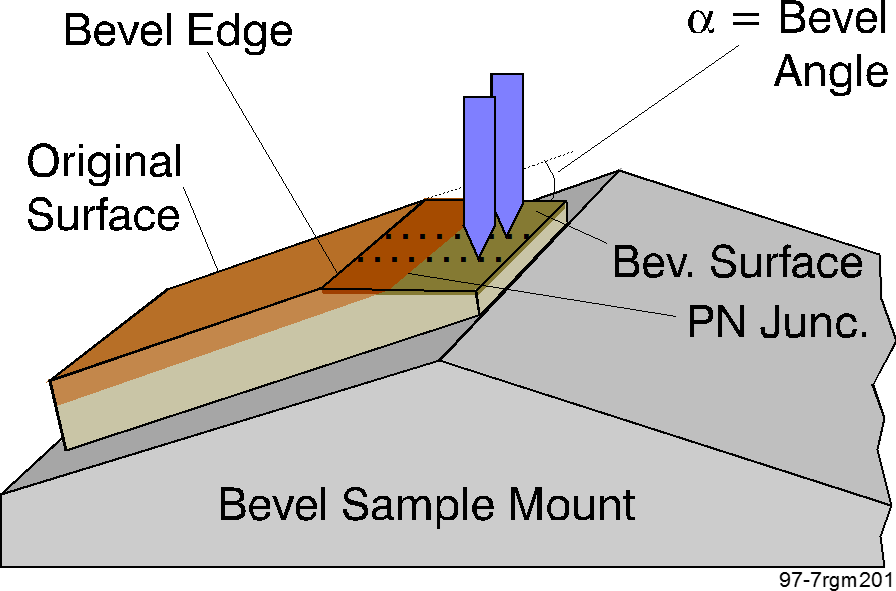
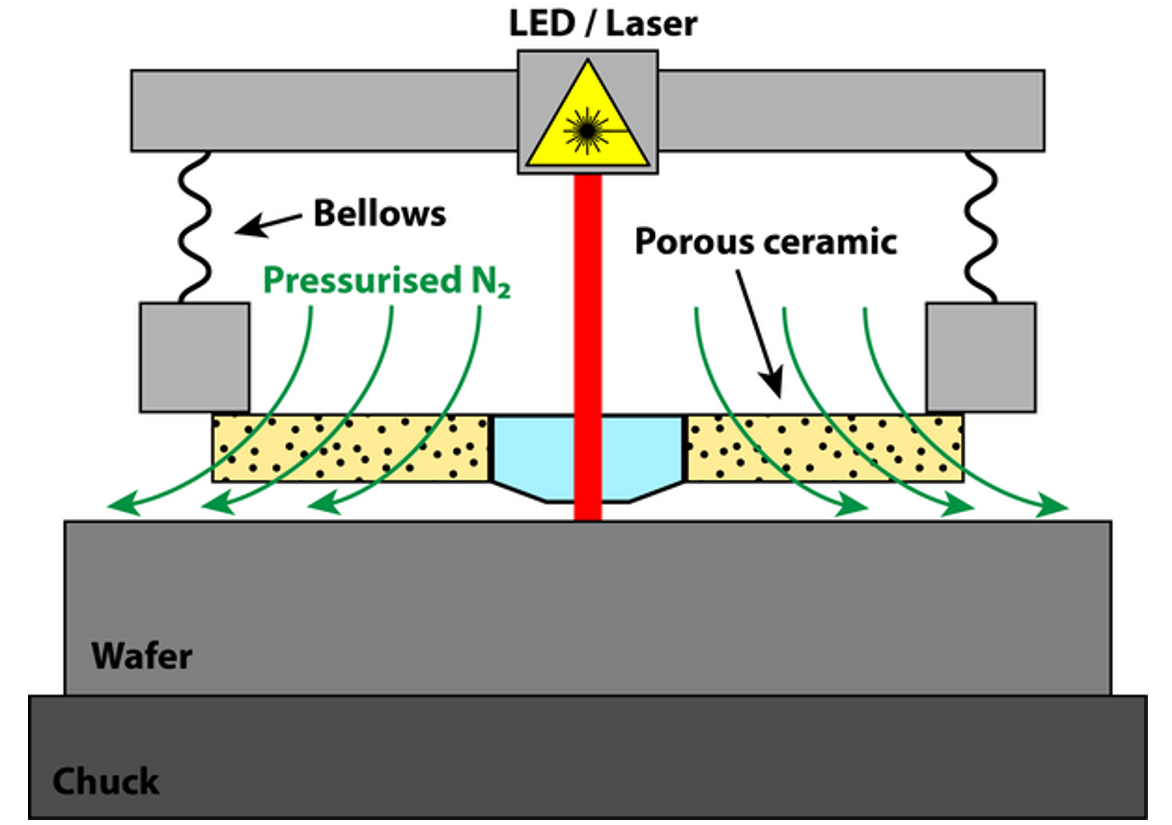 図2.エアギャップCVプロファイリング
図2.エアギャップCVプロファイリング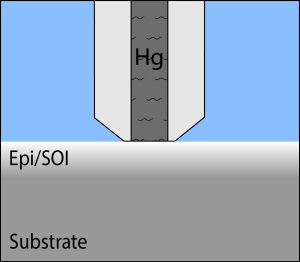 図2.MCVによるCVプロファイリング
図2.MCVによるCVプロファイリング 図2. ac-SPV分析
図2. ac-SPV分析