化合物半導体評価
シリコンカーバイド(SiC)やガリウムナイトライド(GaN)などの化合物半導体は、
高度で使いやすいパワーデバイス・超高周波数デバイスなどの製造を可能にし、こうした新しい材料の半導体デバイス製品は電気自動車やハイブリッドカー
あるいは再生可能エネルギー源に関連するパワー管理・分配デバイスの間でますます普及していきます。
高品質のデバイス製造のために、組成や結晶欠陥・ドーパント濃度・電気・光学特性の定期的なモニタリングが必要です。
セミラボでは、
これらのニーズに答える複数のソリューションをご提供しています。
製品の多くは非接触・非破壊式の検査装置であり様々な状況でデバイスの特徴や性能に直接関連する物理特性を明らかにします。
非接触シート抵抗測定 (Eddy current)とは
半導体デバイス製造プロセスにおいて、シート抵抗測定はとても重要な検査項目です。
シート抵抗マッピングデータは、エピタキシャル成長炉の最適化に用いられ歩留まりの向上に貢献します。
Semilab(旧リハイトン社 Lehighton Electronics, Inc.)の
シート抵抗測定装置LEI-1510シリーズは、非接触非破壊でシート測定の測定が可能です。
LEI-1510シリーズは、
化合物半導体の様々なアプリケーションに対応できるよう設計されており、
特にLEIテクノロジーによるシート抵抗マッピンググラフは高周波デバイスの分野において、
LEIマップとして幅広く認識されております。
結晶欠陥検査装置 EnVision
En-Vision(Enhanced Vision)では、転位欠陥、酸素析出物、積層欠陥などのウェハー内部の結晶欠陥を非接触・非破壊で測定・評価ができます。通常こうした欠陥は、光学的検査では可視化できません。En-Visionでは、ウェハー深さ方向の検出感度を大幅に向上させ、幅広い密度とアプリケーションをカバーすることで、表面近傍では確認ができない深さ方向の応力起因転位欠陥の検出感度を従来の手法(X-TEM/SECCOエッチング)よりも大幅に向上させています(100倍以上)。
EnVisionは、欠陥サイズ(15nm~サブミクロン)と密度(E6~E10/cm3)の両方でハイダイナミックレンジを提供します。
水銀CV測定
水銀CV測定装置MCVシステムでは、空気圧制御式の非破壊プローブ設計とウェハー表面での水銀接触により、コストのかかる金属・ポリ蒸着プロセスを不要にします。接触領域が非常に安定しており、少量の水銀を使うだけで再現性の高いCV・IV測定が可能であり、プロセス開発やプロセスモニタリングなどの用途に役立ちます。MCV法は、バルク/エピタキシャルと誘電層の両方の特性評価に有効です。
 Figure 1.非接触シート抵抗マップ
Figure 1.非接触シート抵抗マップ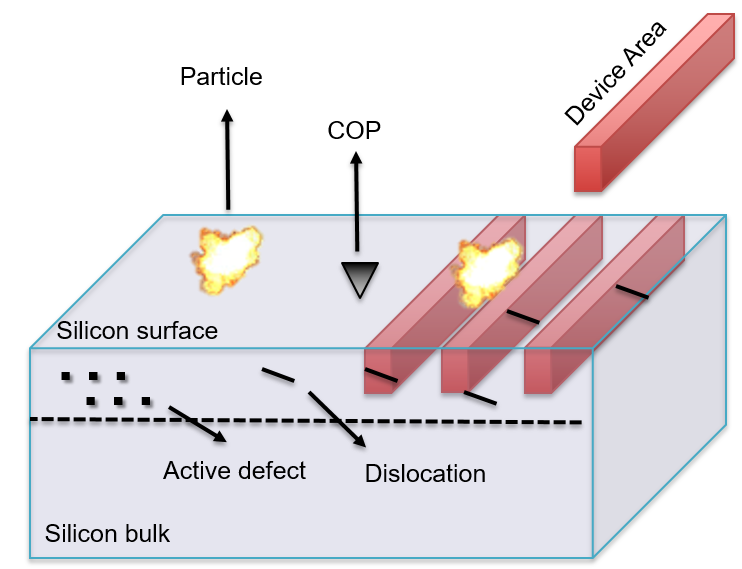 図2.測定理論
図2.測定理論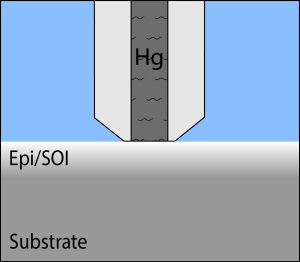 図1.水銀測定
図1.水銀測定