ELAプロセス特性評価(LTPS)
エキシマレーザーアニーリング(ELA)低温シリコン(LTPS)層の製造における主要なプロセスパラメータです。ELAにより、層と最終的にデバイスの重要な最終パラメータ(結晶度、移動度など)の多くが決まります。セミラボは、最適エネルギー密度(OED)を簡単に特定できるメトロロジーの組み合わせを開発しました。こちらの組み合わせは非常に類似した、アニーリングパラメータでアニールされた2つのLTPSサンプルの特性を区別できます。この機能を用いるとELAプロセスの微調整が簡単かつ高速になり、人間の判断によるマクロ検査は一切必要ありません。さらに当社の接触式6ppを使用するとシート抵抗も特定できます。
分光エリプソメトリー
エリプソメトリーは、
絶対的な光学的測定法になり媒質を通過中の光の偏光変化を測定します。
偏光の位相は、反射中の層構造が原因で歪みを呈するため、構造内の媒質材料特性の抽出が可能になります。
偏光の歪みは、複数の光学コンポーネントが光偏光を変調させる複数の方法複で特定できます。
セミラボは、
最新式の回転補償子レイアウトを採用しており、ハイエンドの広帯域補償子が回転角に応じて、
異なる位相転移を生じさせることでエリプソメトリーパラメーターを分光的に特定できます。
エリプソメトリーは、
間接的なメトロロジーであるため厚さ・屈折率の値に対し抽出の際は、
実際構造のモデリングとパラメータフィッティングが必要です。
セミラボの分光エリプソメトリーアナライザー(SEA)ソフトウェアは、
実際の構造モデルを構築するため、幅広い手法・モデルパラメータのフィッティングを行い、
目的の値を取得するための強力なアルゴリズムを装備しています。
チップ品質(ラインムラとµ-PCR)
チップ品質測定法は、電気的なマイクロ波光伝導(μ-PCR)と光学的なラインムラのメトロロジーを組み合わせたものであり、その結果は、薄膜の品質を示す測定値の関数になります。
チップ(またはデバイス)は製造プレート上で選択された領域単位であり、「チップ品質」はμ-PCRとラインムラのパラメータの正規化された加重和です。
μ-PCRの振幅、ライフタイム1-2、ラインムラの輝度の正規化:
- 正規化された値=生の値/正規化係数
ラインムラの相対偏差の値の正規化:
- 正規化された値=正規化係数/生の値
ラインムラは、エキシマレーザーアニーリング(ELA)プロセスで生じた欠陥、不均一性(ムラ)、レーザーの最適エネルギー密度(OED)を特定することでLTPS層(低温のポリシリコン薄膜)の特性を評価するための光学法です。このメトロロジーは、平角照明と平角カメラのシステムで構成されています。



マイクロ波光伝導
フラットパネル分野向けµ-PCD/µ-PCR
TFT分野では、製造のスループットを向上させるために、プロセスを最適化する特性評価法が必要です。マイクロ波フォトコンダクタンス減衰(µ-PCD)とマイクロ波光伝導(µ-PCR)のメトロロジーを用いることで、活性層の電気特性を、成膜の直後、または、それ以降のプロセスで、デバイス自体を形成する前にテストできます。この早期段階の非接触・非破壊の特性評価法は、InGaZnO(IGZO)ベースと低温ポリシリコン(LTPS)ベースのTFTパネルプロセスの両方で利用できます。
4探針プローブによるシート抵抗測定
4探針プローブ(4PP)は、
ドーピング密度・抵抗率・エミッターシート抵抗値のモニタリングを行うために広く使用されている接触測定法です。
電圧と電流の電極を分離することで、接触抵抗の影響を測定結果から排除します。
使用電圧が制限されているため、高抵抗率範囲では測定可能な電流が非常に小さくなり、これが測定に対する制限となります。
当社では6探針プローブ(6PP)法を用いることでこの問題を解決し、探針を2本追加して測定ノイズを可能な限り抑制しています。
接触角
接触角測定法は、
固体の湿潤性を液体によって定量的に調べる手法です。
接触角(Θ)自体は、3つの媒質接触点における気液界面・液固界面のそれぞれ接線間の角度として定義されます。
接触角は、
接着力と凝集力との均衡によって定められ、液固界面上の接着力により液滴が表面全体に広がります。
液体粒子間の凝集力によって、液滴は固体に対する表面を最小化するため、表面上で形成され液滴は小さくなります。
接触角が小さくなると、液滴が平らな固体平面上で拡散する傾向が増大です。
したがって、接触角は湿潤性の逆指標となります。ここで使われる測定法は液滴法です。
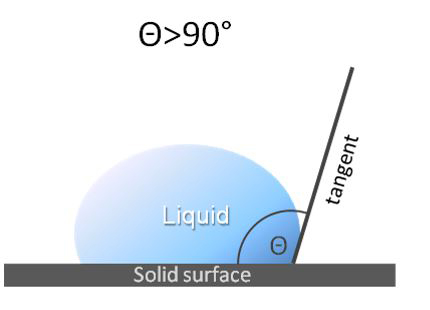
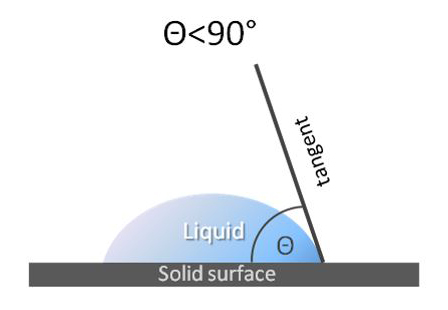
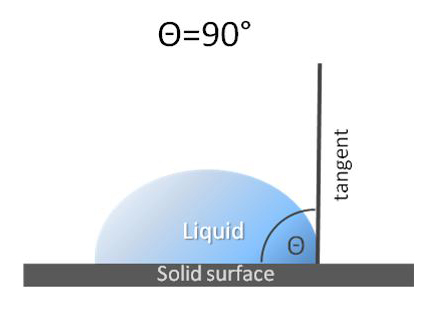
分光ヘイズ&反射率
ヘイズは、
拡散的に散乱された光と全透過光の割合です。
透過光の(直接)正反射部分は光トラップディスクが開状態の場合、トラップに吸収されます。
この状況では収集されたスペクトルは透過光の散乱部分のみを分散させます。
トラップディスクが閉じている場合、測定スペクトルは全透過光で構成されます。
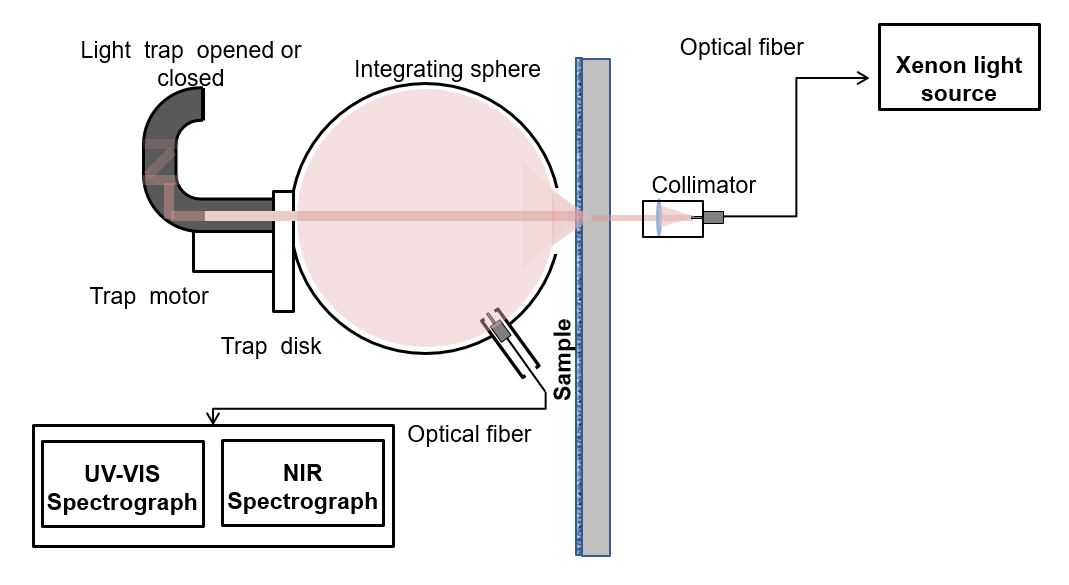

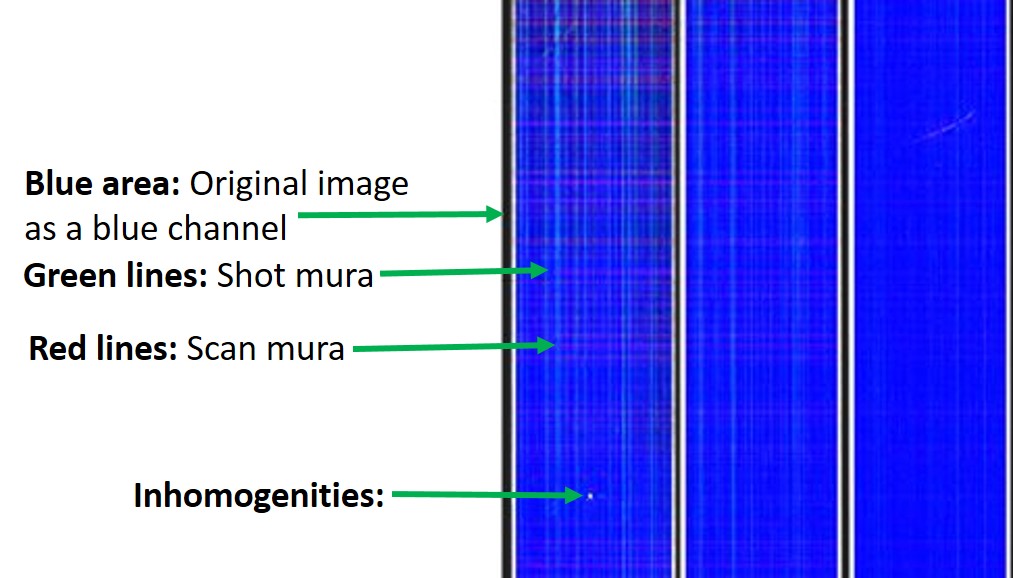
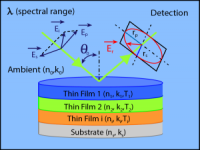
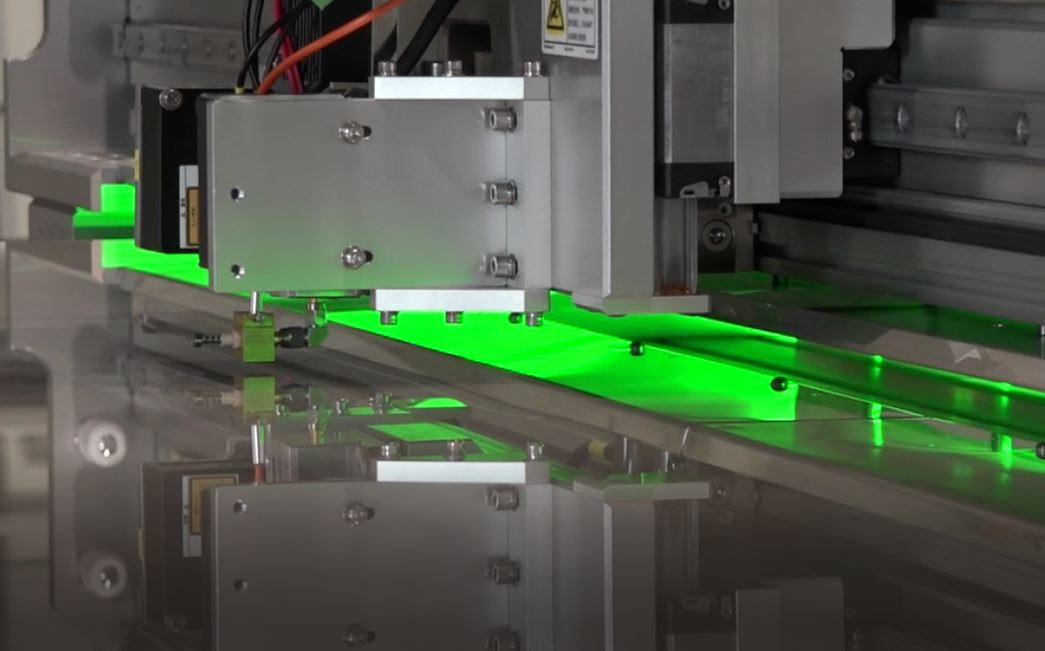

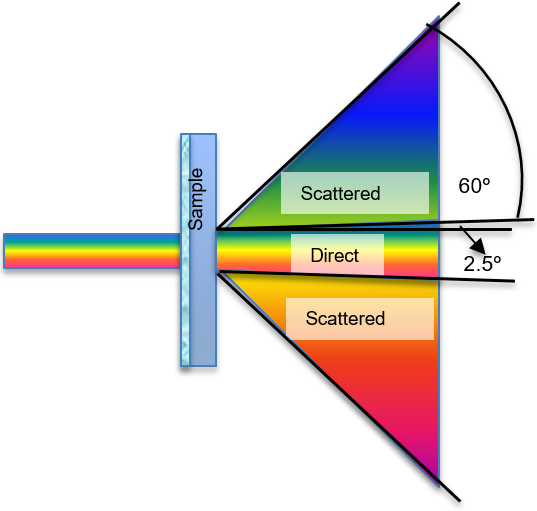 直接&散乱光の角度分布
直接&散乱光の角度分布





