非接触CV測定(FAaST)
Semilab SDIのFAaSTシステムは、半導体デバイス・材料の製造管理と開発で使用される最新式で非接触の電気メトロロジー装置です。この強力な測定手法では、非接触表面電位プローブ法を照射/非侵襲表面帯電と組み合わせて用いることで、半導体ウェハー、誘電体、界面の特性を示す幅広いパラメータを高精度で測定できる一方で、専用の検査試験装置を製作することに伴うコストと時間を節約できます。
非接触CVプロファイリングメトロロジーの主なアプリケーションは、半導体デバイス製造中の誘電体のモニタリングです。ここで最も重要な機能であり、従来の電気的測定との差別化要因となるのは、前処理が不要で非接触式であることです。このため、MOSキャパシタの事前準備が不要となり、製造プロセスと研究開発の両方の環境で測定コストが削減され、データフィードバックが迅速に実行されます。
非接触コロナ-ケルビン法では、空気中のコロナディスチャージ使って電荷を半導体ウェハーに与えます。ウェハー反応が振動キャパシタプローブ(通常はケルビンプローブ)でモニターされ、このプローブが表面電圧(Vcpd)を測定します。暗期と強照射の両方で表面電圧をモニタリングすることで、次の2つの重要な電圧成分を分離できます。
- 誘電圧(VD)
- 半導体表面電位(Vsb)
得られた電荷-電圧データの分析により、Dit、Vfb、Qtot (誘電体電荷)、CD、EOT、誘電体リークなどの電気パラメータが提供されます。
p型Si上の誘電体のVcpd vs Qcoronaデータの例

Si上の各種誘電体のDitスペクトルの例
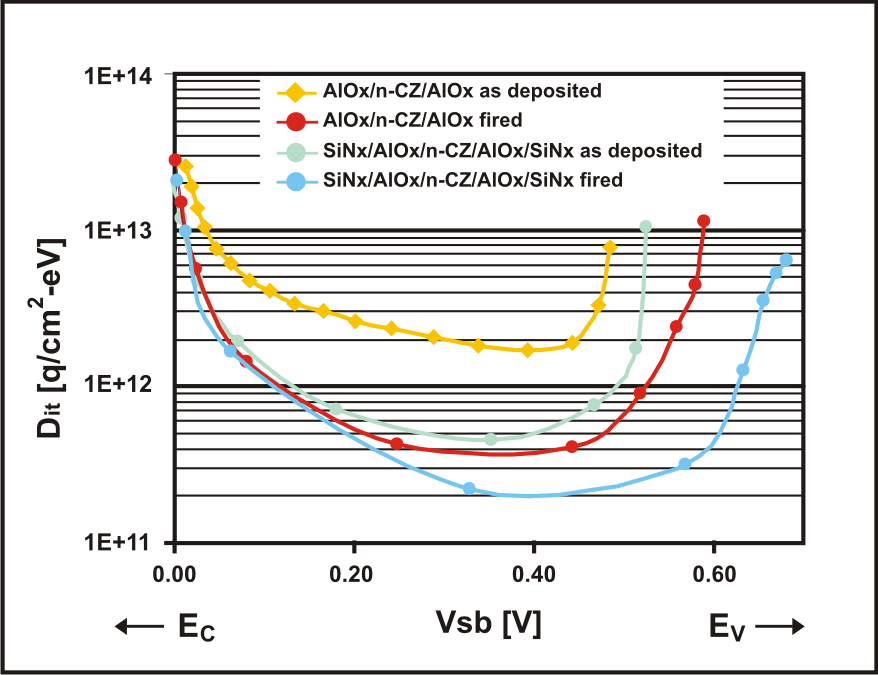
このメトロロジーの主なアプリケーションは、半導体デバイス製造中の誘電体のモニタリングです。ここで最も重要な機能であり、従来の電気的測定との差別化要因となるのは、前処理が不要で非接触式であることです。このため、MOSキャパシタの準備が不要となり、製造と研究開発の両方の環境で測定コストが削減され、データフィードバックが迅速に実行されます。
特徴
- ・非接触の電気的なCV・IVメトロロジーにより、IC製造や研究開発環境で誘電体と界面の特性評価を比類のない正確さ・精密さで実現
- ・モニターウェハーの測定にマクロ構成で使用可能
- ・ケルビンフォース顕微鏡(KFM)を用いた独自のミクロ構成オプションにより、スクライブラインテスト部位と製品用ウェハーの活性デバイス領域でCVとIVの特性を測定
- ・製造環境間での有効性が実証されている装置マッチング
- ・時間分解電圧測定により、ナノメートル以下の誘電体で、誘電体リークの特定と、対応するリーク補正された真のCV曲線の測定が可能
- ・誘電体キャパシタンス抽出用の独自CVシミュレータが、非常に高い界面トラップ密度が存在する中で動作
- ・最先端の超薄誘電体、高k誘電体、層間誘電体へのアプリケーションが実証済み
- ・エンドオブラインデバイスデータとの優れた相関