トレンチ形状検査装置
トレンチ形状検査装置は、プロセスウェハーの測定を高速かつ再現可能な方法で非破壊・非接触で行う薄膜メトロロジー検査システムです。
IRシリーズの製品では、独自のMBIR(Model-Based Infrared Reflectometry)技術により、半導体集積回路の製造で使用されるエッチング構造と膜の寸法、膜厚、組成、均一性を、高スループット、低COO、非接触・非破壊で測定できます。独自のMBIR技術と分析機能により、主要なサンプル測定に対して、定期的なシステム校正作業頻度が少なくなり、基板の差異による影響がなくなります。
独自のMBIR技術には、裏面反射を抑制して無関係なデータを除去する特殊な光学系が含まれています。このため、主要なサンプル測定に対して、分析機能が向上し、定期的なシステム校正作業頻度が少なくなり、基板の差異による影響がなくなり、正確で再現可能な測定が可能になります。
トレンチ形状検査装置では、Si, SiCパワーデバイスのディープトレンチ構造やTSV形状、DRAMのキャパシタートレンチの深さ、CD測定、リセス形状を非接触・非破壊で測定します。独自技術MBIR(Model Based Infrared)によりハイアスペクト比のトレンチの検査・評価が可能です。また、エピ膜のドープ濃度の縦方向プロファイルの測定やアモルファス・カーボンの膜厚測定にも対応しています。
スポットサイズ構成が異なる2つのMBIR光学系があります。
- 大型スポット光学系は主に、膜や、パターン付きウェハーのデバイス領域の測定に使用されます。
- 小型スポット光学系では、パターン付きウェハー上のスクライブラインテスト構造を測定できます。
 図4.測定結果
図4.測定結果
プロセスアプリケーション
赤外線スペクトル範囲は、ウェハー上の各種の薄膜やエッチング構造からの自由キャリア、分子振動、干渉効果に敏感であるため、この手法は幅広い半導体アプリケーションに採用できます。3D構造デバイスに有効媒質計算を適用すると、この手法で未来技術ノードに対応することができます。
| メモリーアプリケーション |
|
|
|---|---|---|
| ドープエピ(Epi)&インプラントアプリケーション |
|
|
| HARトレンチ&貫通電極アプリケーション |
|
|
| 3D積層アプリケーション |
|
|
| BEOL膜アプリケーション |
|
|
| エピアプリケーション |
|
特徴
- ・モデルベースの手法
- ・高スループット
- ・中IR~近IR波長域により、様々なアプリケーションに対応
- ・裏面反射を除去する独自の光学系で高精度測定を実現

 図2.パターン付きウェハー
図2.パターン付きウェハー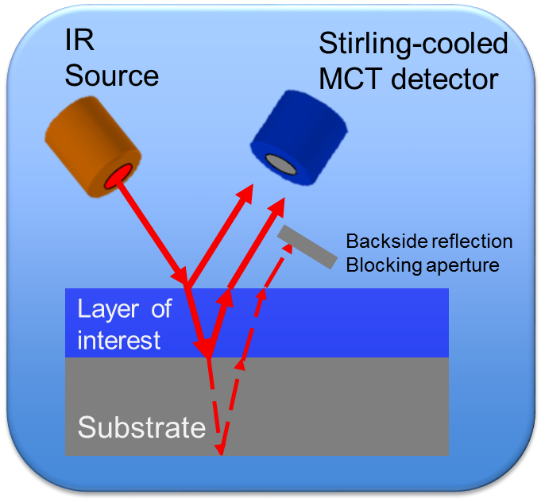 図3.MBIR技術
図3.MBIR技術







