FTIR反射率測定装置(EIR)
セミラボのFTIR反射法は、干渉波形(インターフェログラム)減算法を適用可能であると同時に、高度で多用途のSEA分析ソフトウェアを用いた光学解析モデルベースのアプローチも選択可能です。解析モベルベースのアプローチでは、エピ層の厚さを考慮に入れるだけでなく、膜質評価として有効である屈折率の判定も可能になります。
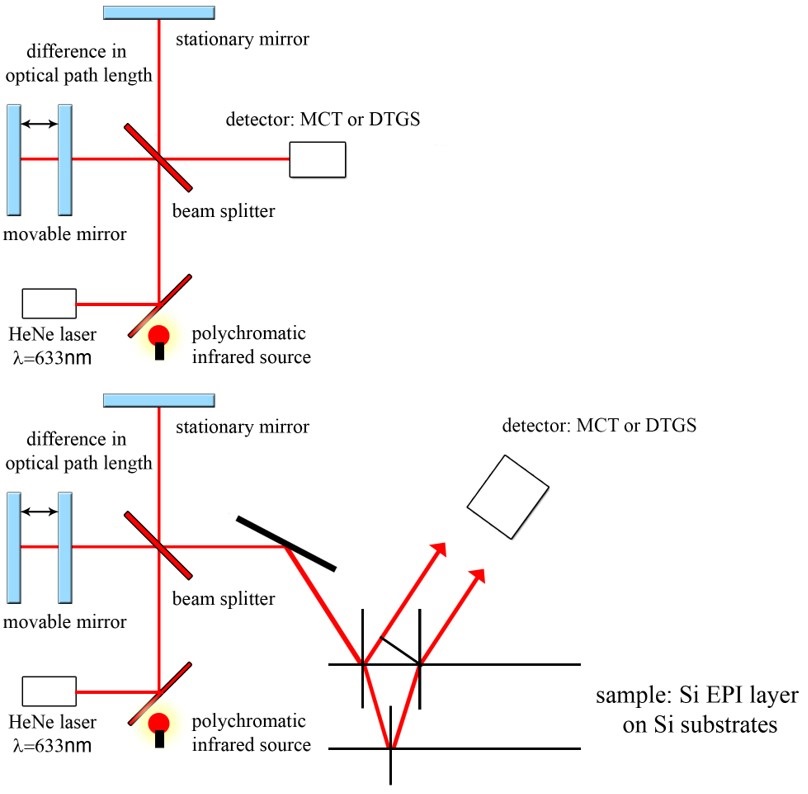 図3.FTIR干渉計 光路
図3.FTIR干渉計 光路
・反射モードでのサンプルの測定は、IR波長域で実現
・干渉縞を反射スペクトルで観察
・安定した検出器が室温で作動(メンテナンス不要で、低コスト)
・評価は、直接反転法(厚いエピ層の場合)または光学モデリング(厚さ<2µmのエピまたは複雑な積層の場合)で実行

図4.シリコンウェハー上のシリコンエピ層、IR反射測定モード
 図5.測定例
図5.測定例
上の測定例では、100nmエピ膜厚の膜厚プロファイルは、ウェハーの中心は薄く、ドーナツ型のように変化しています。
特徴
- ・非接触・非破壊の光学的測定
- ・単層&多層構造に対応 – 各層ごとの厚さ測定
- ・適合材料:Si、SiC、SOI、SiGe、III – V
- ・オプションの測定法:直接、または光学モデリング
製品ラインナップ
 図2.FTIR反射法
図2.FTIR反射法






