エピ膜厚測定
CVDプロセスでシリコンのブランケット層をシリコン基板に追加することで、抵抗率、N型P型、結晶欠陥密度などの物理特性を変化させることができます。このCVDプロセスはエピ(Epi、またはエピタキシャル)成膜と呼ばれます。エピ層の厚さのモニタリングは、エピウェハーの製造プロセスの一環として行われています。このモニタリングは、サンプルベースで行われますが、エピタキシャルリアクタが正しく設定されていることを確認するためにのみ行われることもあります。
セミラボでは、赤外反射法などの検査装置により、エピ膜厚モニタリングの非接触光学ソリューションをご提供しています。
テクノロジー
FTIR反射率測定装置(EIR)
セミラボのFTIR反射法は、干渉波形(インターフェログラム)減算法を適用可能であると同時に、高度で多用途のSEA分析ソフトウェアを用いた光学解析モデルベースのアプローチも選択可能です。解析モベルベースのアプローチでは、エピ層の厚さを考慮に入れるだけでなく、膜質評価として有効である屈折率の判定も可能になります。
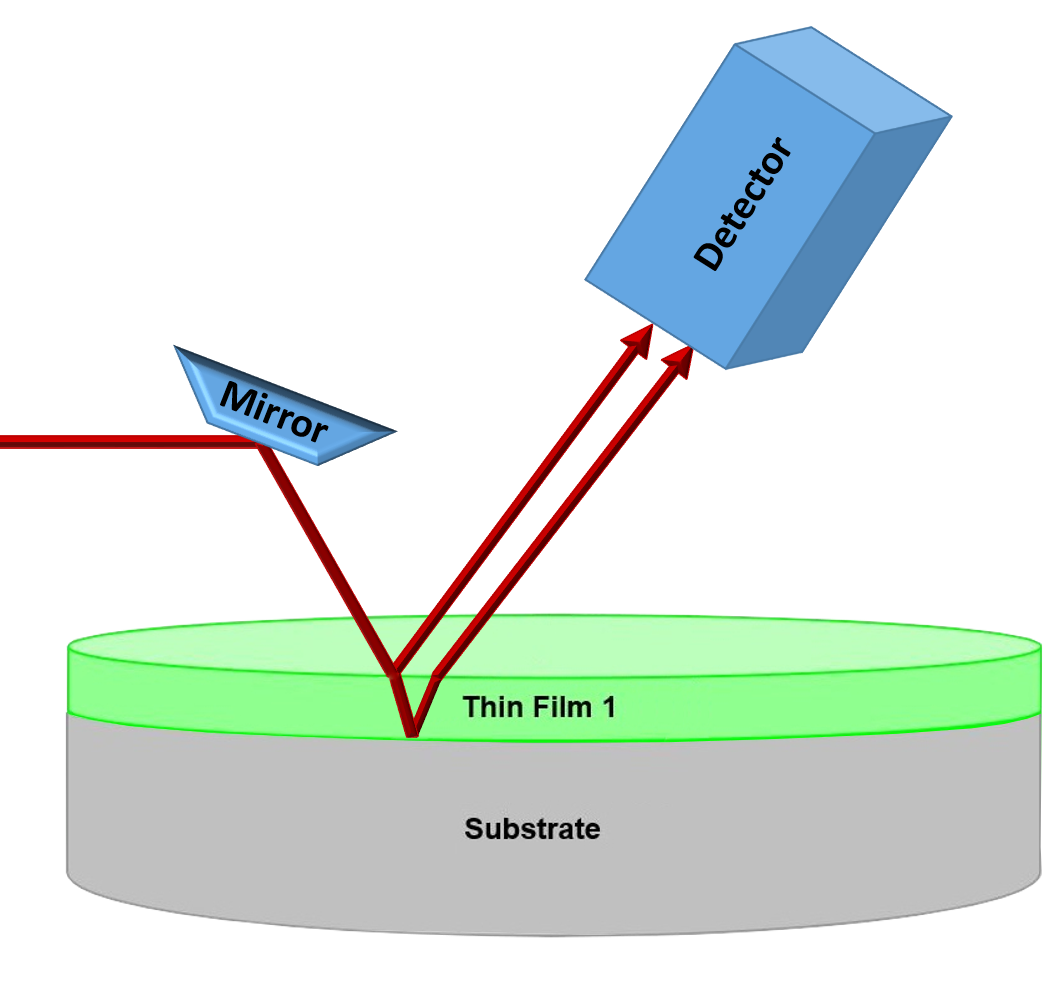 図1.エピ成膜
図1.エピ成膜 図2.FTIR反射法
図2.FTIR反射法






