偏光赤外イメージング法(ストレスモニター)
偏光応力イメージング(PSI)技術は、シリコンウェハーや、ウェハー状態になる前のシリコン小片を、IR光の偏光解消度の測定に基づいて分類するのに適しています。
結晶材料で確認できる各種の欠陥の例:

図2.転位欠陥

図3.転位欠陥

図4.スリップライン - 応力画像

図5.スリップライン - 自動欠陥マスク

図6.スリップライン

図7.スリップライン

図8.二重線

図9.クラック

図10.エピ(Epi)プロセスで生じたエッジ欠陥
最終的な応力画像の解像度は、直径300mmのウェハーで最大36メガピクセルです(ピクセルスケールが50μmの場合)。
測定原理は、イメージングシステムによる偏光解消度の検出です。
IR源からの光がポラライザーを介してシリコンサンプルに投影されます。その後、光がシリコンウェハーを通過します。ウェハーの下側には、別のポラライザー(アナライザー)が最初のポラライザーに垂直に配置されます。ウェハーの応力場によって生じる偏光解消度信号がカメラで検出されます。
表面パーティクルも、光散乱の増加によって偏光を解消します。サンプルの両面でこれらのパーティクルを検出するために、別々の光学的設定/装置が使用され、これが本体に組み込まれています。
測定の評価:
画像を平行ポラライザーで取得。光強度:Pp(平行)
画像を交差ポラライザーで取得。光強度:Pc(交差)
偏光解消度の計算が可能:
D=1-(Pp-Pc)/Pp+Pc
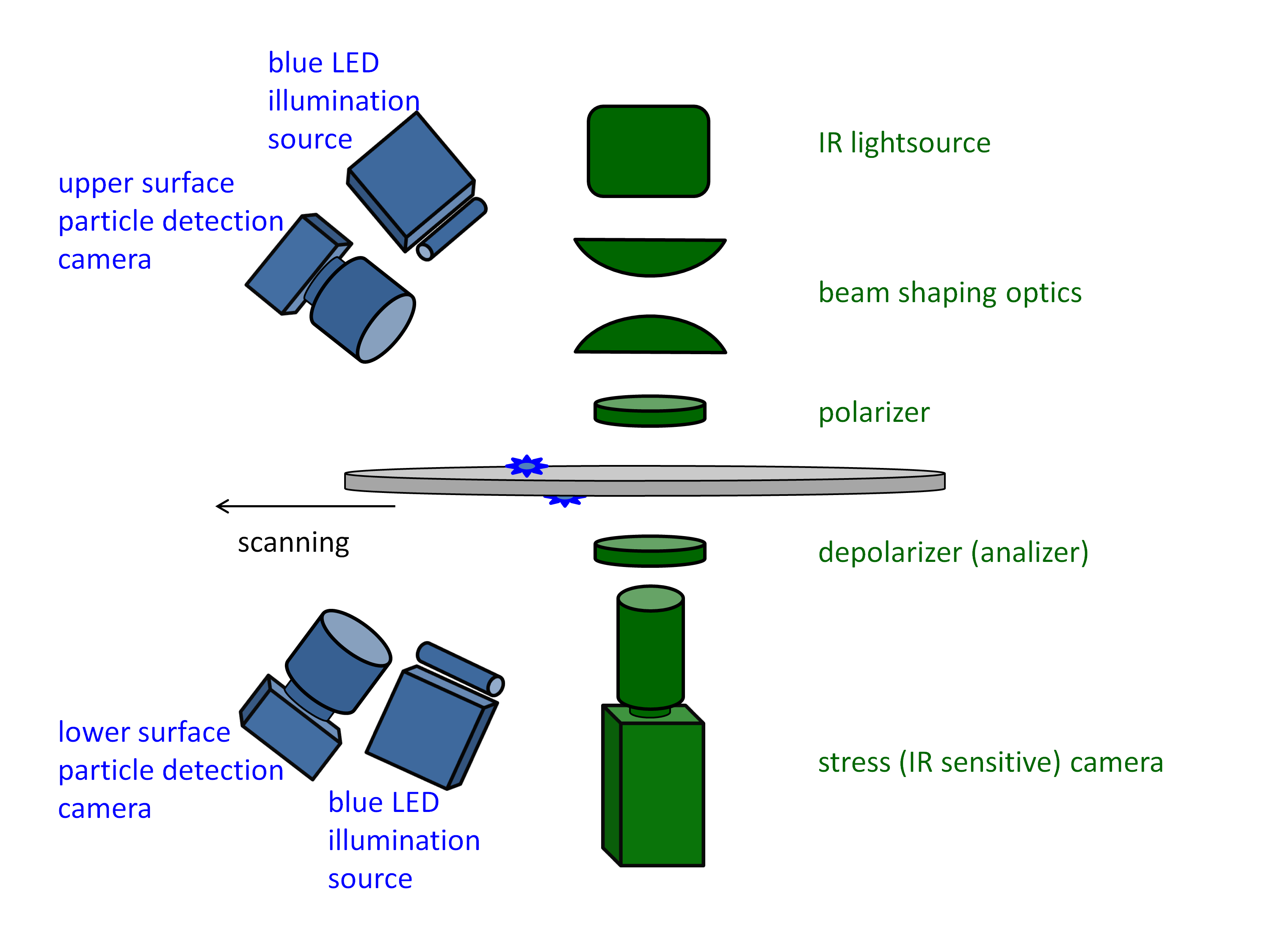 図11.光路
図11.光路
偏光解消度は無次元量です。Dは小さな値であるため(Pp>>Pc)、通常はDU(偏光解消度単位)で表されます(1DU=10-6)。偏光解消度は透過波のリタデーションに関連しているため、応力-光学法で表される応力に比例します。ベアシリコンウェハーの場合、透過光は通常、平行ポラライザーではウェハー上で一様であり、偏光解消度の計算は不要です。欠陥の自動検出の場合は、交差ポラライザーの画像取得で十分です。
測定の出力:
- ・元の応力画像(または、DUマップが計算されている場合はDUマップ)
- ・欠陥マップ(欠陥を強調した白黒画像)
- ・計算された欠陥領域(ウェハー全体と、分割された欠陥)
- ・分割された欠陥の座標(局部・拡張欠陥の中心点)
- ・DUマップが計算された場合は、DU(最大、平均)統計
特徴
- ・非接触
- ・非破壊
- ・透過法によるウェハー内の欠陥検出
- ・高分解能でのフルウェハーマッピング







