赤外光共焦点顕微鏡法(SIRM)
赤外光共焦点顕微鏡は結晶欠陥の評価をウェハーにダメージを与えることなしに行える優れた装置であり、30nmまでの結晶欠陥サイズを検出できます。非破壊・非接触の測定方法であり、パターン認識機能や精密X-Yマッピングステージを装備しているため、ウェハーの任意の点の測定が実行できます。欠陥の深さ方向スキャンも可能です。
検出した信号は高度な分析ソフトウェアによって評価され、このソフトウェアには自動欠陥発見アルゴリズム、背景補正、散乱除去の機能が含まれています。取得したデータから、データベースでの検索が容易なファイルを作成することができ、このファイルには設定や評価結果がすべて入力されます。
赤外光共焦点顕微鏡法は、以下の結晶欠陥の検査に最適です。
- エピ(Epi)層やバルクシリコンの積層欠陥
- スリップライン
- パーティクル
- 転位(酸素析出物上の転位など)
欠陥特定だけでなく、SIRM製品シリーズは、サンプル表面と対物レンズとの距離を設定できるため、BMD密度と無欠陥層の深さ方向プロファイルも測定できます。
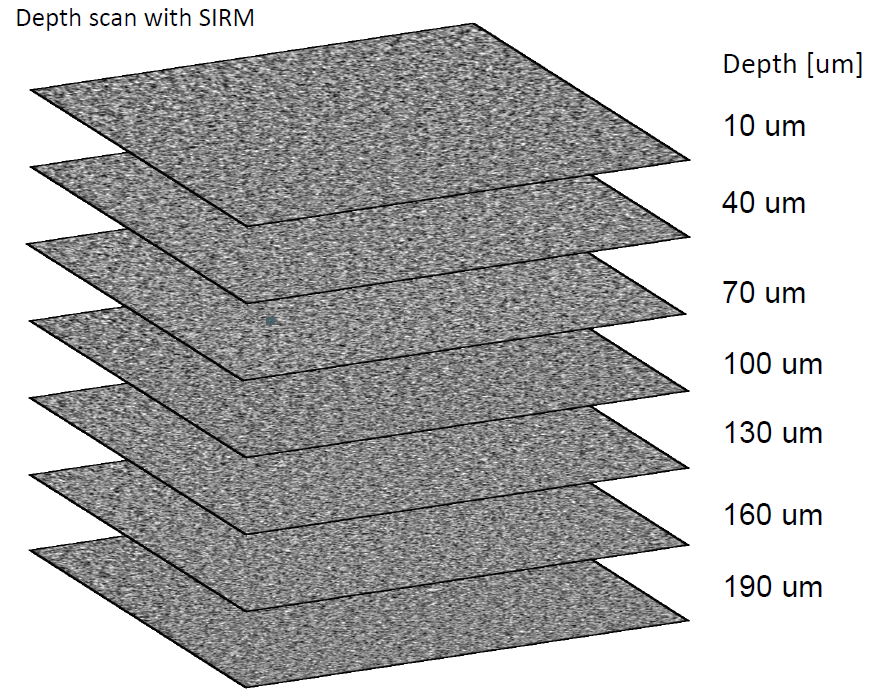 図3.SIRMでの深さ方向スキャン
図3.SIRMでの深さ方向スキャン
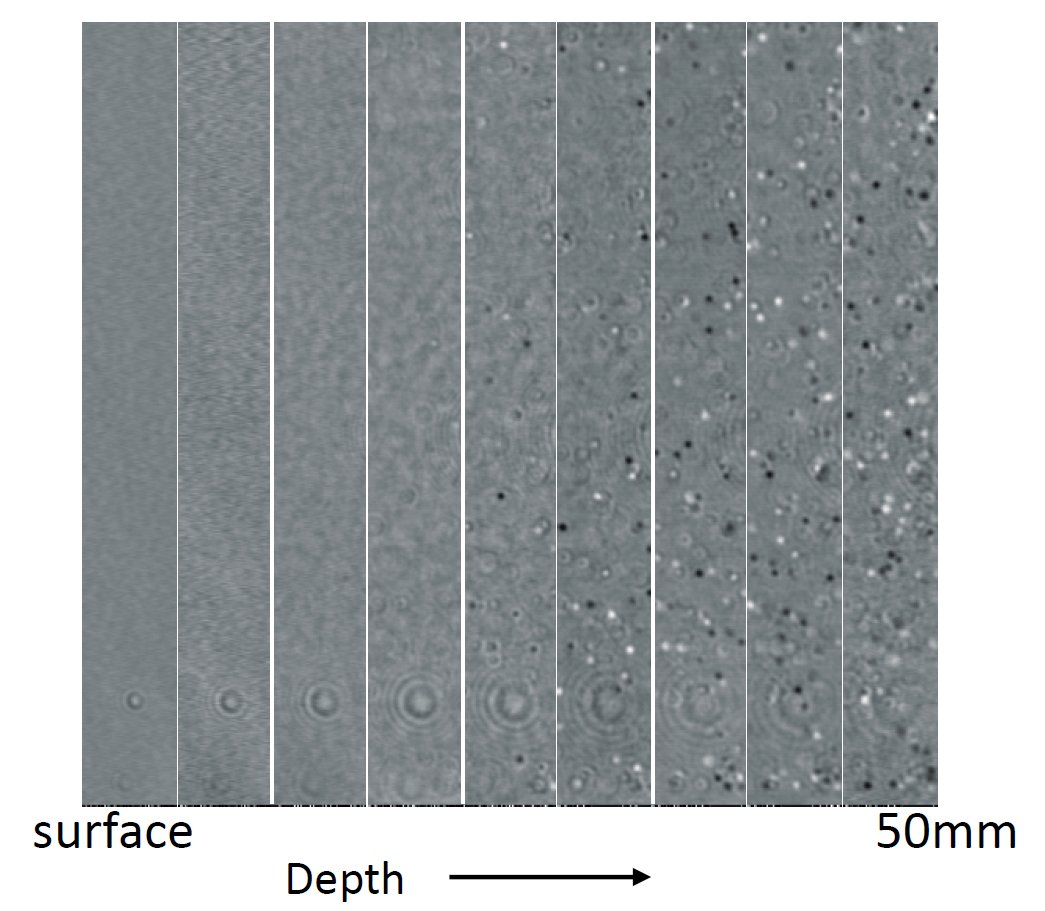 図4.スリップライン
図4.スリップライン
 図5.BMD密度結果
図5.BMD密度結果
特徴
- ・非接触・非破壊の分析
- ・サンプルの準備が不要
- ・X-Y面とX-Z面での画像収集
- ・背面の状態に左右されない
- ・高濃度ドーピングされたエピウェハーの測定(3mΩcmまでのエピ基板)
- ・レーザーマーキングのオプション
製品ラインナップ
SIRM
バルク微細欠陥アナライザーは非接触・非破壊の光学測定器であり、
バルク微細欠陥(BMD)の完全な特性評価(バルクと半導体ウェハーの表面付近の酸素・金属析出物、Void、積層欠陥、スリップライン、転位など)が可能です。
赤外光共焦点顕微鏡法では、手動でのカウントよりもはるかに信頼できる方法で欠陥量を正確かつ高速に特定できます。10μmまでの深さに対応しています。

 図2.測定理論
図2.測定理論