分光エリプソメトリー
エリプソメトリーは絶対的な光学的測定法であり、媒質を通過中の光偏光の変化を測定します。
偏光の位相は、反射中の層構造が原因により歪みを呈するため、構造内の媒質材料特性の抽出が可能になります。
偏光の歪みは、複数の光学コンポーネントが光偏光を変調する複数の方法で特定できます。
セミラボでは、
最も進んだ回転補償子を採用しており、ハイエンドの広帯域補償子が回転角に応じて異なる位相転移を生じさせ、
エリプソメトリーパラメータを分光的に特定できます。
エリプソメトリーは間接的なメトロロジーであるため、
厚さ・屈折率の値を抽出するには、実際にある構造のモデリングとパラメータフィッティングが必要です。
セミラボの分光エリプソメトリーアナライザー(SEA)ソフトウェアは、
実際にある構造モデルを構築するための幅広い手法やモデルパラメータをフィッティングにかけ、
目的の値を取得するための強力なアルゴリズムを装備しています。
分光エリプソメトリー測定法には多数の長所があります。第一の長所は、光学法であり、よって非接触・非破壊式であることです。この測定法では、多層構造中の各層の層厚と光学機能を測定します。感度が高く、層構造中を移動する光ビームの位相転移の測定に基づいているため、位相角測定が光の絶対強度に依存しません。白色光源とモノクロメーターを用いると、サンプルに関するスペクトル情報を取得できます。
エリプソメトリーでは、複雑なフレネル反射係数の比率を測定します。これは複素数であるため、振幅項と位相転移項に分けることができ、それぞれエリプソメトリー角であるΨとΔに対応します。これらのパラメータには、層構造の物理特性(層厚や屈折率など)が含まれています。これは超越的で高度に非線形な方程式であるため、モデルベースのアプローチを用いて数値法で解く必要があります。この手法では、層構造をモデルの厚さと光学機能を用いて検討します。数値的回帰手法では、相対位相転移を計算し、測定量と比較します。
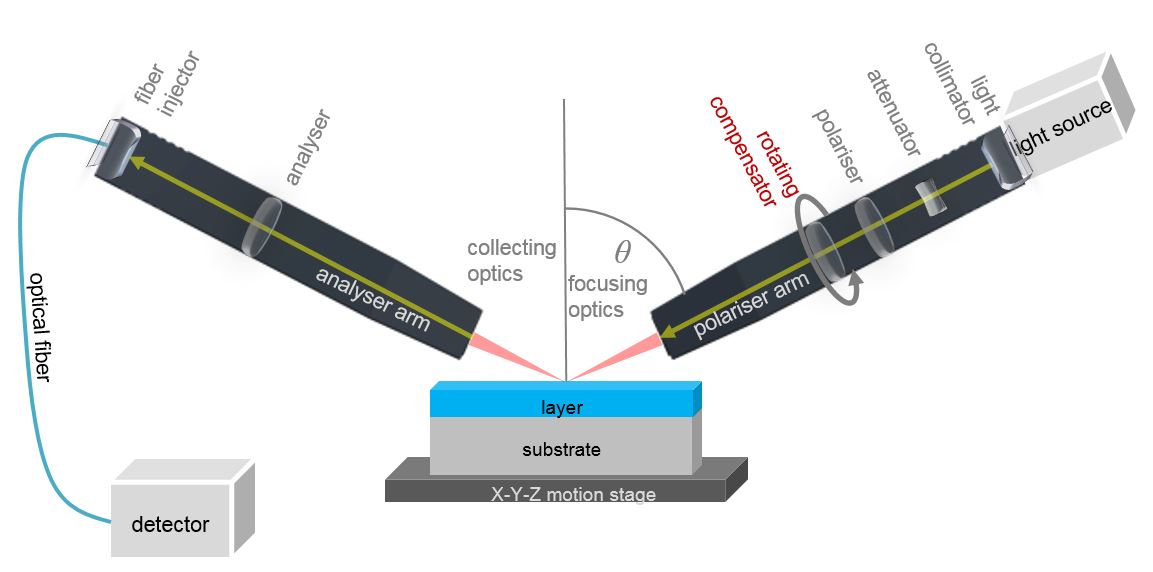
特徴
非接触・非破壊の光学的測定を次の対象に実行できます。
- 基板
- 単層
- 多層サンプル
取得されるパラメータ:薄膜の膜厚と光学特性
アプリケーションは非常に幅広く、半導体、有機、光学系、バイオ、太陽電池、レーザーダイオード、照明、ポーラス層などにわたります。
測定モード:
- 薄膜膜厚と光学機能向けの分光エリプソメトリー(複雑な多層構造を含む)
- 異方性材料向けに一般化されたエリプソメトリー
- 透明基板用の透過エリプソメトリー
- スキャトロメトリーvs波長と入射角度
- ミュラーマトリクス(11または16要素)を3D異方性材料のスキャトロメトリーと組み合わせて独自に提供
- 単純な異方性材料用のジョーンズ行列
- 反射率&透過率vs波長&入射角度
- ポラリメトリー
- ポロシメトリー:薄膜中の細孔サイズと細孔率の測定
- in-situ測定モードで成膜またはエッチングプロセス中にリアルタイム制御が可能