薄膜光学特性評価
薄膜(ITO・OLED・LTPS・IGZO・SiNx・SiOx・フォトレジストetc)の
厚さ・光学特性は主要なプロセス管理パラメータです。
セミラボの分光エリプソメーターは、
高速(反射率計に類似した測定速度)+正確な測定を任意の
サイズパネルに実行できます。
当社の最新式分析ソフトウェアでは、
光学的バンドギャップエネルギー・透過率・ラフネス・結晶度関連(LTPSの場合)の
パラメータも特定可能です。
SiOx/ガラス構造など従来の光メトロロジーでは測定が困難な場合があり、
FPTで使用されているエリプソメーターの原理により
低コントラスト構造も正確に測定できます。
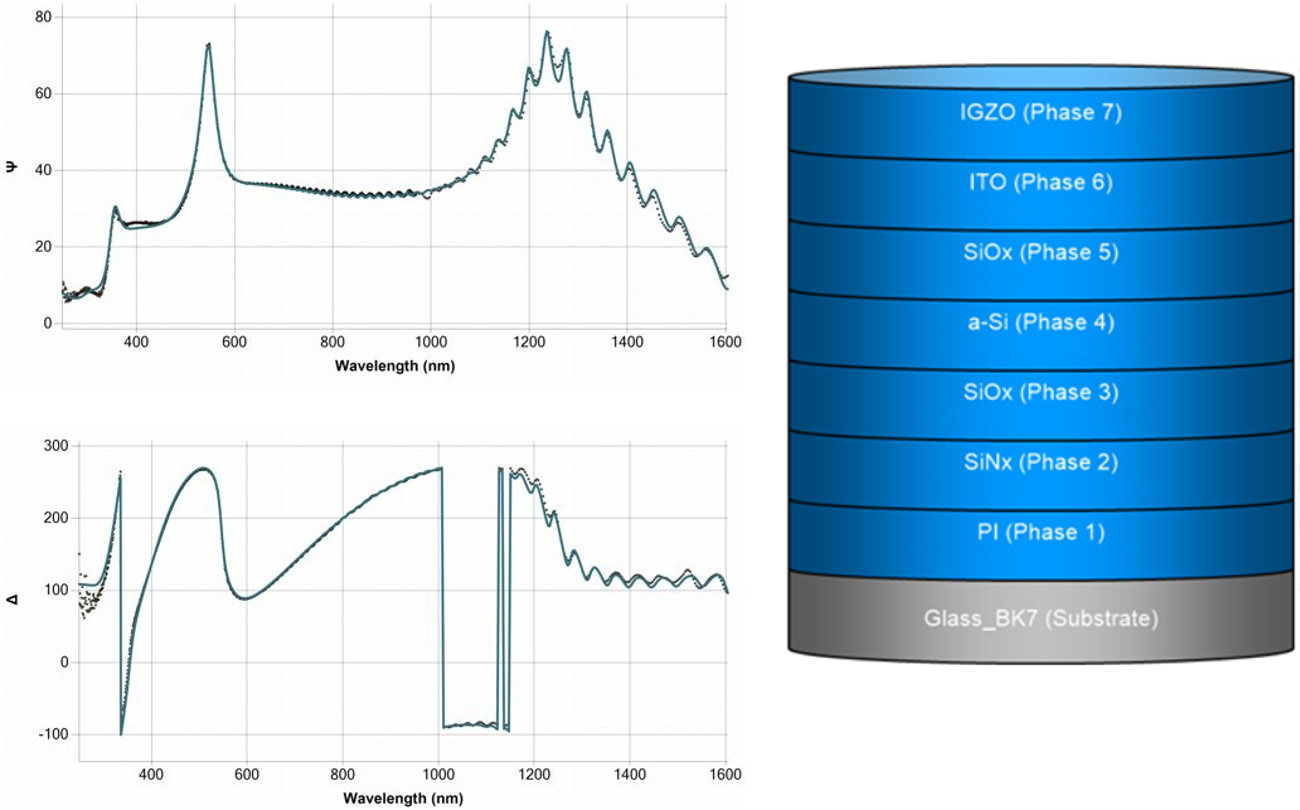
分光エリプソメトリー
エリプソメトリーは絶対的な光学的測定法であり、媒質を通過中の光の偏光の変化を測定します。偏光の位相は、反射中の層構造が原因で歪みを呈するため、この構造内の媒質の材料特性の抽出が可能になります。
偏光の歪みは、複数の光学コンポーネントが光偏光を変調させる複数の方法で特定できます。セミラボでは、最も進んだ回転補償子レイアウトを採用しており、ハイエンドの広帯域補償子が回転角に応じて異なる位相転移を生じさせることで、エリプソメトリーパラメータを分光的に特定できます。
エリプソメトリーは間接的なメトロロジーであるため、厚さや屈折率の値を抽出するには、実際の構造のモデリングとパラメータフィッティングが必要です。セミラボの分光エリプソメトリーアナライザー(SEA)ソフトウェアは、実際の構造のモデルを構築するための幅広い手法や、モデルパラメータをフィッティングして目的の値を取得するための強力なアルゴリズムを装備しています。