フルトーン/ハーフトーン(フォトレジスト)
フォトレジスト厚を把握することは、ディスプレイ製造における複数の段階で非常に重要です。しかし、UVに敏感な厚い層や、非常に小型(1~2µm)のチャネルにおける測定では、これが困難になることがあります。セミラボは、このアプリケーション向けに特別に設計されたメトロロジーヘッドを用いて、この両方の問題を解決するソリューションをご提供できます。
分光反射率計
分光反射率計は、薄膜の特性評価に広く使用されています。この測定では、薄膜層の厚さと光学特性に関する情報が提供されます。スポットサイズを5µmまで小さくできるため、サブピクセルの内部を測定でき、この結果、測定用に別のテストパッドは必要ありません。
セミラボのSRメトロロジーでは、幅広い波長と高輝度のXeランプを使用しているため、お客様固有のプロセス要件に応じて測定の波長域を選ぶことができます。より厚い層に対しては、近赤外拡張機能を追加でき、数十マイクロメートルまでの測定が可能です。フォトレジストや他の敏感な層をUV光から保護するUVフィルターも追加できます。大きな光強度により、取得時間を数ミリ秒にまで短縮できます。また、レーザー光変位センサーと2Dカメラが内蔵されているため、高速な焦点合わせと正確な動きが可能です。
分光反射率計とエリプソメトリーはどちらも同じ分析エンジンを使用しています。したがって、異なる2つのメトロロジーで測定している場合でも、同じ光学モデルを同じ材料に対して使用できます。
 有機層の厚さマップ
有機層の厚さマップ

有機層で測定され適合された反射率曲線
イメージング分光反射率計
イメージング分光反射率計は、小さい領域(通常50×50µm~500×500µm)の高い空間分解能を調べるために使用されます。したがって、主な2つのアプリケーションは、ハーフトーンプロセス管理(1µmのチャネル幅までのフォトレジスト厚特性評価が可能)と印刷方式有機ELの厚さマップです。高輝度のXeランプを光源として使用し、高精度のモノクロメーターを用いることで、高速で正確な測定を実行できます。波長分解能は数ナノメートルまで調整可能であり、波長域は測定した層の厚さと光学特性に応じて選択できます。
広波長域の光源はモノクロメーターでフィルタリングされます。単色光がサンプルに到達し、2D画像が同時に取得されます。選択した各波長に対してこのプロセスが繰り返されます。この結果、一連の画像が提供され、各画像が所定の波長での結果を表します。これらの画像を使って、選択した各位置の反射スペクトルをソフトウェアが計算します。
イメージング分光エリプソメトリーには非常に精密な焦点合わせが必要ですが、これは、高速・精密な圧電モーターを利用した内蔵の焦点調整システムによって行われます。
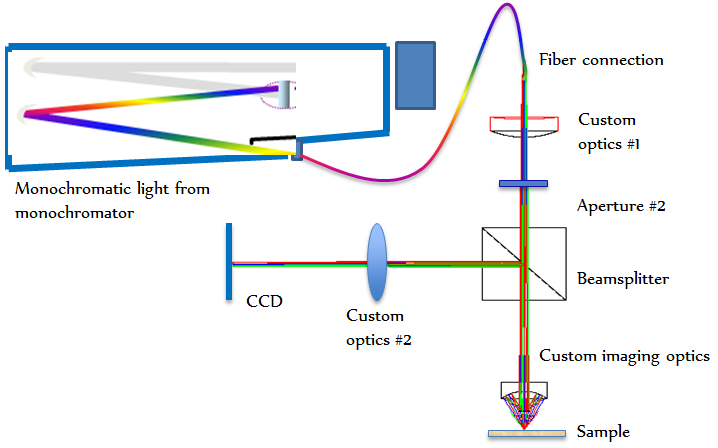
イメージング分光反射率計は分光反射率計およびエリプソメトリーと同じ分析エンジンを使用しているので、異なる2つのメトロロジーで測定している場合でも、同じ光学モデルを同じ材料に対して使用できます。このため、正確な分光エリプソメトリー(OLEDサンプルなどに必要)に基づいた精密な光学モデルを使用できます。
H/Tプロセス管理
チャネル内のPR厚